Электронно-дырочный переход (p – n -переход) – это переходный слой между двумя областями полупроводника с разной электропроводностью, в котором существует диффузионное электрическое поле.
Области разделены плоскостью, где изменяется тип преобладающих примесей и называемой металлургической границей. Вблизи металлургической границы существует обедненный подвижными носителями заряда слой, где присутствуют неподвижные ионизированные атомы примеси (рис. 3.1).
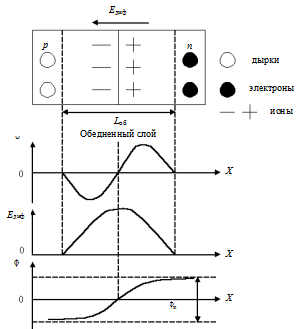
Рис. 3.1. Электронно-дырочный переход
Неподвижные ионы в обедненном слое создают объемные электрические заряды  положительной и отрицательной полярности. Тем самым создается диффузионное электрическое поле напряженностью Е диф и контактная разность потенциалов
положительной и отрицательной полярности. Тем самым создается диффузионное электрическое поле напряженностью Е диф и контактная разность потенциалов  к. Величина контактной
к. Величина контактной
разности потенциалов зависит от концентрации акцепторной примеси
NA, ND и температуры:
 .
.
Толщина обедненного слоя также зависит от концентрации примесей:
 ,
,
где А – коэффициент, определяемый материалом полупроводника.
3.2. Ток через p–n- переход
Через p–n -переход течет ток, представляющий сумму диффузионной и дрейфовой составляющих. Диффузионный ток образуется основными носителями заряда, для движения которых диффузионное поле является тормозящим. Увеличение диффузионного тока увеличивает напряженность поля Е диф, контактную разность потенциалов  и потенциальный барьер
и потенциальный барьер  . Это приводит к уменьшению тока. Таким образом устанавливается равновесие.
. Это приводит к уменьшению тока. Таким образом устанавливается равновесие.
Дрейфовый ток образуется неосновными носителями заряда, для которых диффузионное поле является ускоряющим.
В равновесном состоянии сумма диффузионного и дрейфового токов равна нулю:
I диф + I др = 0.
3.3. Прямое включение p – n -перехода
Прямым называется такое включение, при котором создаваемое внешним напряжением поле направлено против диффузионного поля (рис. 3.2).

Рис. 3.2. Прямое включение p–n -перехода
В результате контактная разность потенциалов уменьшается, потенциальный барьер снижается, ток основных носителей заряда через переход увеличивается.
3.4. Обратное включение p – n -перехода
Обратное включение p – n -перехода характеризуется тем, что напряженность поля, создаваемого внешним напряжением, совпадает по направлению с напряженностью диффузионного поля (рис. 3.3).

Рис. 3.3. Обратное включение p – n -перехода
В результате контактная разность потенциалов увеличивается, потенциальный барьер повышается, ток основных носителей заряда через переход уменьшается.
3.5. Вольт-амперная характеристика (ВАХ)
идеализированного p–n- перехода
Вольт-амперная характеристика p – n -перехода – это зависимость тока через переход от приложенного к нему напряжения.
Идеализация p–n -перехода заключается в принятии следующих
допущений.
1. Прилегающие к переходу области p и n характеризуются нулевым удельным сопротивлением. Поэтому внешнее напряжение прикладывается непосредственно к p – n -переходу.
2. В области p – n -перехода отсутствуют процессы генерации и рекомбинации свободных носителей заряда. Тогда ток через переход в зависимости от приложенного к переходу внешнего напряжения U внеш, т.е. вольт-амперную характеристику, можно описать формулой Шокли:
 ,
,
где I 0 – тепловой ток, который создается неосновными носителями заряда и зависит от трех факторов:
1) концентрации неосновных носителей заряда, обратно пропорциональной концентрации примесей;
2) ширины запрещенной зоны  Чем больше
Чем больше  тем мень-
тем мень-
ше I 0;
3) температуры. С увеличением температуры растет скорость генерации носителей заряда и увеличивается их концентрация.
3.6. Зонная (энергетическая) диаграмма
p–n- перехода
При U внеш = 0. Состояние равновесия. Уровень Ферми имеет одно значение для всей структуры (рис. 3.4).
При U внеш  0. Прямое включение p–n -перехода (рис. 3.5).
0. Прямое включение p–n -перехода (рис. 3.5).

Рис. 3.4. Зонная диаграмма равновесного p–n -перехода

Рис. 3.5. Зонная диаграмма при прямом включении p - n -перехода
При U внеш  0. Обратное включение p–n -перехода (рис. 3.6).
0. Обратное включение p–n -перехода (рис. 3.6).

Рис. 3.6. Зонная диаграмма при обратном включении p – n -перехода
3.7. Отличия ВАХ реального
и идеализированного p–n -переходов
Реальные p–n -переходы являются, как правило, несимметричными. При этом концентрация примеси в одной области превышает концентрацию примеси в другой. Область с большей концентрацией называется эмиттером, с меньшей – базой. Меньшая концентрация примесей означает меньшую электропроводность и большее удельное сопротивление. Поэтому в реальных p–n -переходах пренебрегать удельным
сопротивлением базы нельзя. Эквивалентная схема реального
p–n -перехода имеет вид (рис. 3.7).

Рис. 3.7. Эквивалентная схема реального p–n -перехода
Вторым отличием реального p–n -перехода от идеализированного является наличие в обедненном слое процессов генерации и рекомбинации носителей заряда. Поэтому при обратном включении ток через переход не постоянен, а зависит от приложенного к переходу напряжения (рис. 3.8).

Рис. 3.8. Отличие ВАХ реального p – n -перехода от идеализированного
Третье отличие заключается в присутствии явления пробоя при
обратном включении p–n -перехода.
3.8. Пробой p–n -перехода
Пробой проявляется как резкое увеличение тока через
p – n -переход при незначительном изменении приложенного обратного напряжения.
Различают три вида пробоя.
Лавинный пробой – возникает за счет лавинного размножения неосновных носителей заряда путем ударной ионизации. Напряжение, при котором он появляется, увеличивается с ростом температуры (рис. 3.9).

Рис. 3.9. ВАХ при лавинном пробое
Туннельный пробой – возникает за счет перехода электронов из связанного состояния в свободное без сообщения им дополнительной энергии. С ростом температуры напряжение пробоя уменьшается (рис. 3.10).

Рис. 3.10. ВАХ при туннельном пробое p–n -перехода
Тепловой пробой – это пробой, развитие которого обусловлено выделением тепла вследствие прохождения тока через переход. В отличие от лавинного и туннельного является необратимым, т. е. в результате пробоя переход перестает работать. С ростом температуры напряжение пробоя уменьшается (рис. 3.11).
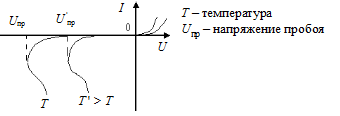
Рис. 3.11. ВАХ при тепловом пробое p–n -перехода
3.9. Зависимость ВАХ p – n -перехода
от температуры
С ростом температуры ток через p–n -переход при прямом включении растет из-за увеличения энергии носителей электрического заряда, которые за счет этого легче преодолевают потенциальный барьер.
При обратном включении p–n -перехода с ростом температуры ток через него увеличивается за счет повышения скорости генерации носителей заряда в переходе (рис. 3.12).
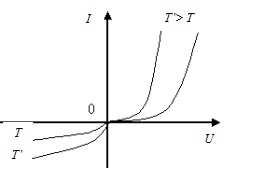
Рис. 3.12. Зависимость ВАХ p–n -перехода от температуры
3.10. Зависимость ВАХ p–n- перехода от материала полупроводника
Вольт-амперная характеристика p – n -перехода зависит от ширины запрещенной зоны  энергетической диаграммы материала полупроводника.
энергетической диаграммы материала полупроводника.
Чем больше ширина запрещенной зоны  , тем меньше скорость тепловой генерации и меньше концентрация неосновных носителей, создающих обратный ток I 0. Следовательно, обратный ток меньше.
, тем меньше скорость тепловой генерации и меньше концентрация неосновных носителей, создающих обратный ток I 0. Следовательно, обратный ток меньше.
При прямом включении p – n -перехода ток через него будет тем больше, чем меньше ширина запрещенной зоны. Действительно, ток через p – n -переход определяется как
 .
.
С увеличением значения  ток I 0 уменьшается и ток I также уменьшается.
ток I 0 уменьшается и ток I также уменьшается.
Для наиболее распространенных полупроводниковых материалов Ge, Si и GaAs ВАХ соотносятся следующим образом (рис. 3.13).

Рис. 3.13. Зависимость ВАХ p–n -перехода
от материала
3.11. Емкость p–n -перехода
В обедненном слое p – n -перехода присутствуют объемные заряды, которые образованы зарядами ионизированных донорных и акцепторных примесей. Эти заряды равны по величине и противоположны по знаку. Поэтому обедненный слой подобен конденсатору. Так как заряды определяют потенциальный барьер, то емкость называется барьерной. Ее величина равна
 , где
, где  ,
,
где S – площадь p–n -перехода, U – внешнее напряжение, приложенное к переходу, n = 0,5 для резкого перехода, n = 0,3 для плавного перехода.
 Зависимость величины барьерной емкости от величины приложенного к переходу напряжения называется вольт-фарадной характеристикой (рис. 3.14).
Зависимость величины барьерной емкости от величины приложенного к переходу напряжения называется вольт-фарадной характеристикой (рис. 3.14).
При прямом включении p–n -перехода происходит процесс инжекции неосновных носителей заряда. Появляются избыточные концентрации неосновных носителей в каждой области и в соответствии с условием электрической нейтральности равные им избыточные концентрации основных носителей. Таким образом, в n -области (как в конденсаторе) оказываются в равном количестве положительный заряд избыточных дырок (неосновные носители) и отрицательный заряд избыточных электронов (основные носители). Аналогично p -область ведет себя как конденсатор с отрицательным зарядом избыточных электронов (неосновные носители) и равным ему положительным зарядом избыточных дырок (основные носители).
Процесс накопления избыточных зарядов принято характеризовать диффузионной емкостью, которая учитывает изменение избыточных носителей (дырок и электронов) в обеих областях при изменении напряжения.
Диффузионная емкость определяется прямыми диффузионными токами дырок Ip и электронов In (отсюда название емкости) и временем жизни неосновных носителей  и
и  :
:
 .
.
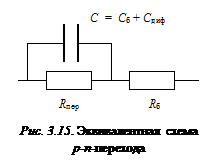 Диффузионные токи Ip и In растут с увеличением прямого напряжения на p-n -переходе и быстро обращаются в нуль при обратном. Поэтому зависимость С диф от напряжения примерно повторяет ход прямой ветви ВАХ p–n -перехода.
Диффузионные токи Ip и In растут с увеличением прямого напряжения на p-n -переходе и быстро обращаются в нуль при обратном. Поэтому зависимость С диф от напряжения примерно повторяет ход прямой ветви ВАХ p–n -перехода.
Эквивалентная схема p–n -перехода, учитывающая его емкостные свойства, приведена на рис. 3.15.
3.12. Контакт металл–полупроводник
Контакты между полупроводником и металлом широко используются для формирования внешних выводов от полупроводниковых областей приборов и создания быстродействующих диодов. Тип контакта металл–полупроводник определяется работой выхода электронов из металла и полупроводника, током проводимости полупроводника и концентрацией примеси в нем.
Работа выхода электронов – это энергия, необходимая для перевода электронов с уровня Ферми на потолок верхней свободной зоны.
При идеальном контакте металла с полупроводником и без учета поверхностных состояний происходит диффузия электронов преимущественно из материала с меньшей работой выхода. В результате диффузии и перераспределения зарядов нарушается электрическая нейтральность прилегающих к границе раздела областей, возникают контактное электрическое поле и контактная разность потенциалов
 ,
,
где А м, А п – работа выхода электронов из металла и полупроводника.
Переходный слой, в котором существует контактное (или диффузионное) электрическое поле и который образован в результате контакта между металлом и полупроводником, называется переходом Шоттки.
В зависимости от типа электропроводности полупроводника и от соотношения работ выхода в полупроводнике может возникать обедненный или обогащенный слой. Если работа выхода в металле меньше работы выхода в полупроводнике А м < А п, то электроны с большей вероятностью будут переходить из металла в полупроводник. Это приводит к образованию в полупроводнике обедненного слоя, если полупроводник p -типа, или даже инверсного слоя, если А м << А п. Если полупроводник n -типа, то образуется обогащенный слой.
В обедненных слоях пространственный заряд формируется в результате нарушения компенсации заряда ионизированных примесей основными носителями, а в обогащенных – из-за накопления основных носителей заряда. Обогащенный слой обусловливает малое сопротивление приконтактной области полупроводника по сравнению с сопротивлением объема полупроводника. Поэтому такой переход не обладает выпрямляющими свойствами и образует омический контакт. При наличии обедненного или инверсного слоя переход Шоттки обладает выпрямляющими свойствами, так как внешнее напряжение, падая в основном на высокоомном переходе, будет изменять высоту его потенциального барьера, изменяя условия прохождения носителей заряда через переход.
Характерной особенностью выпрямляющего перехода Шоттки в отличие от p–n -перехода является разная высота потенциальных барьеров для электронов и дырок. В результате через переход Шоттки может не происходить инжекция неосновных носителей заряда в полупроводник. Поэтому они не накапливаются и нет необходимости в их рассасывании. Отсюда высокое быстродействие перехода Шоттки.
Гетеропереходы
Гетеропереходом называется переходный слой с существующим там диффузионным электрическим полем между двумя различными по химическому составу полупроводниками.
Ширина электрических зон различных полупроводников различна. Поэтому на границе раздела двух полупроводников (на металлургическом контакте гетероперехода) получается разрыв дна зоны проводимости и потолка валентной зоны. В результате разрывов высота потенциальных барьеров для электронов и дырок в гетеропереходе оказывается различной. Это является особенностью гетеропереходов, обуславливающей специфические свойства гетеропереходов в отличие от p – n -переходов.
Гетеропереходы могут образовываться полупроводниками с различным типом проводимости: p – n, p – p, n – n. В зависимости от типа проводимости и ширины запрещенной зоны энергетических диаграмм ток через переход может определяться как электронами, так и дырками. Например, через контакт германия p -типа и арсенида галлия n -типа течет в основном электронный ток (рис. 3.16).
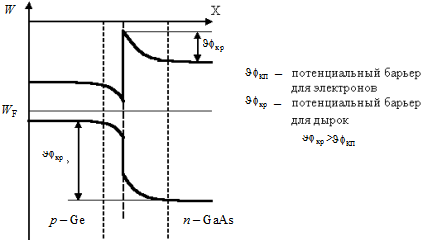
Рис. 3.16. Зонная диаграмма перехода Ge (p -типа) – GaAs (n -типа)
Через переход германий p -типа, арсенид галлия p -типа течет в основном дырочный ток (рис. 3.17).
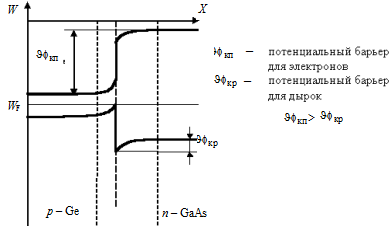
Рис. 3.17. Зонная диаграмма перехода Ge (p -типа) – GaAs (p -типа)
Для формирования качественного гетероперехода необходимо совпадение типа, ориентации и периода кристаллических решеток контактирующих полупроводников, чтобы кристаллическая решетка одного полупроводника с минимальным количеством нарушений переходила в кристаллическую решетку другого полупроводника. Наиболее широкое применение в полупроводниковых приборах имеют гетеропереходы между полупроводниками на основе арсенидов, фосфидов и антимонидов галлия и алюминия. Благодаря близости ковалентных радиусов галлия и алюминия изменения химического состава полупроводников в гетеропереходе происходят без изменения периода кристаллической решетки. Гетеропереходы создают также на основе многокомпонентных твердых растворов, в которых при изменении состава в широких пределах период решетки не изменяется.
3.14. Структура металл–диэлектрик–полупроводник
Структуры металл–диэлектрик–полупроводник (МДП) составляют основу полевых МДП транзисторов, фотоэлектрических приборов, конденсаторов, управляемых напряжением, а также широко используются в интегральных схемах.
Простейшая МДП структура содержит полупроводниковый кристалл – подложку, слой диэлектрика, металлический электрод – затвор, омический контакт к подложке (рис. 3.17).

Рис. 3.17. Простейшая МДП структура
Структура имеет два вывода – затвор и контакт к подложке и является МДП конденсатором, емкость которого зависит от напряжения U между затвором и выводом подложки.
Напряжение затвора создает электрическое поле, проникающее через тонкий (0,03…0,1 мкм) слой диэлектрика в приповерхностный слой полупроводника, где оно изменяет концентрацию носителей. В зависимости от значения напряжения наблюдаются режимы обогащения, обеднения или инверсии.
Эквивалентную схему МДП структуры можно представить последовательным включением двух конденсаторов СD – емкость диэлектрика и Сg:
 ,
,
где Jп – плотность заряда нескомпенсированных ионов примесей и подвижных носителей заряда в полупроводнике, jпов – напряжение в поверхностном слое полупроводника, S – площадь затвора.
Наиболее широко применяется МДП структура на основе кремния, где диэлектриком служит диоксид кремния, затвором – пленка алюминия.